Simcenter Flotherm

全球電子散熱設計軟體第一選擇 Simcenter Flotherm
FloTHERM 是一套針對電子散熱領域專用的分析軟體,分析快速且準確度高,符合電子產業開發週期性短的特性,透過分析可在產品開發初期就得到工程師想知道的結果,縮短產品開發週期,減少打樣次數與成本,在現今產品競爭激烈且持續Cost down的需求下,本產品可以解決日益嚴重的散熱問題,用最低的成本找出最佳方法。
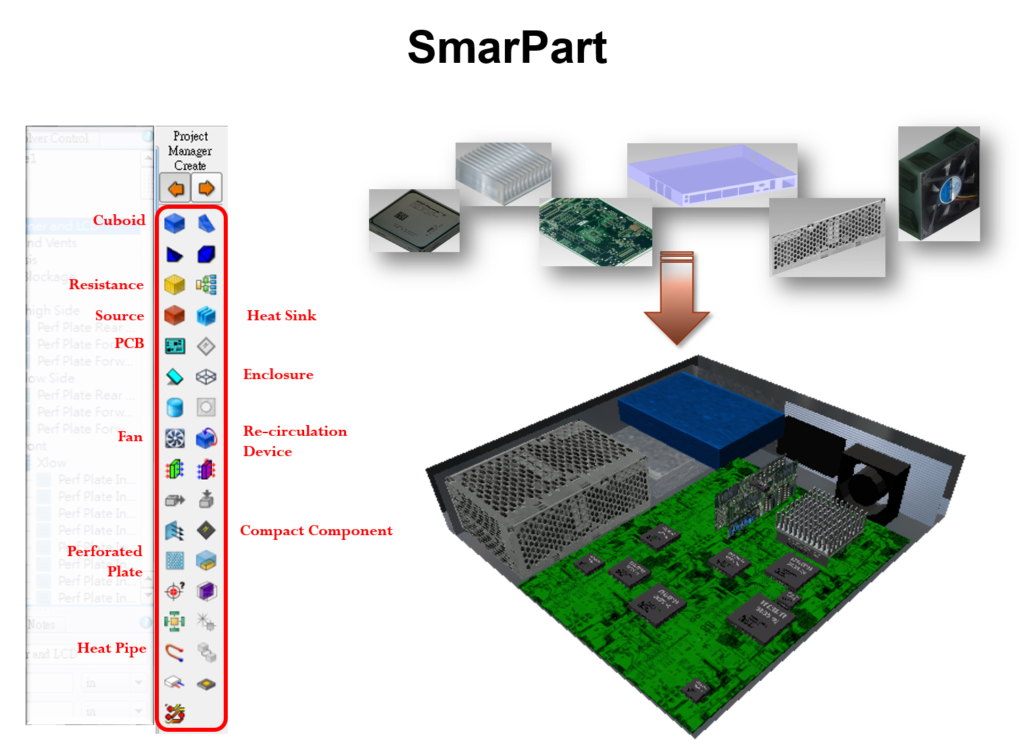
模組化元件SmartParts &資料庫Library
本產品專用的模組化元件(SmartParts)提供軸流風扇、鼓風機、致冷晶片、熱管、散熱鰭片等等;使用者只需要建立樂高積木一樣,能夠迅速、準確地為大量電子設備建模Flotherm內建大量的固體及流體資料庫,使用者可針對自己的需求自訂資料庫,減少因重複建模浪費的時間。SmartParts 模組化元件凝聚了 Mentor Graphics 公司 Mechanical Analysis Division 20 多年來在電子冷卻建模領域的經驗,旨在提高建模效率,讓使用者可大幅減少前處理建模時間,在最短時間內得到最佳化的解熱方案。

正交嵌入式網格Grid
本產品使用卡式座標網格系統(Cartesian Grid),當今最穩定的高效數值求解網格技術,同時採用先進的非連續嵌入式網格和 Cut Cell 網格切割技術,不僅求解速度快,相關細節物理現象都能得到很好的解析度。
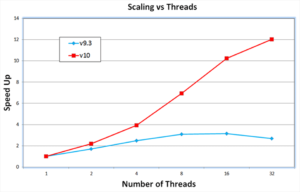
高速求解器 Solver及平行運算模組 SMP parallel solver
FloTHERM 的求解器一直專注地為解決電子設備散熱應用而打造。求解器基於笛卡爾網格系統,運算結果精確,單位元網格之運算速度全球最快。針對大面積的不規則模型,本產品採用“局域化”網格技術,可讓曲面的模型也得到良好的解析結果。目前Flotherm系列產品都已標準配備平行運算模組-SMP parallel solver且支援64位元系統,讓使用者從元件等級到系統甚至是機房等級的應用都可輕鬆跑出分析結果。

暫態分析 Transient Analysis
本產品強大的暫態分析能力使得其能夠預測大範圍的瞬態行為。可將散熱量與時間變化對應的資訊用.csv格式檔導入軟件,定義隨時間變化的散熱情況。據此,可生成關於元件溫度隨時間變化的精確報告。


自動化太陽輻射 Solar Radiation
本產品提供了強大的太陽輻射計算功能,能自動計算在不同緯度與時間下的太陽照射強度,在戶外設備與外太空環境中必須充分考慮太陽照射對電子設備的影響。
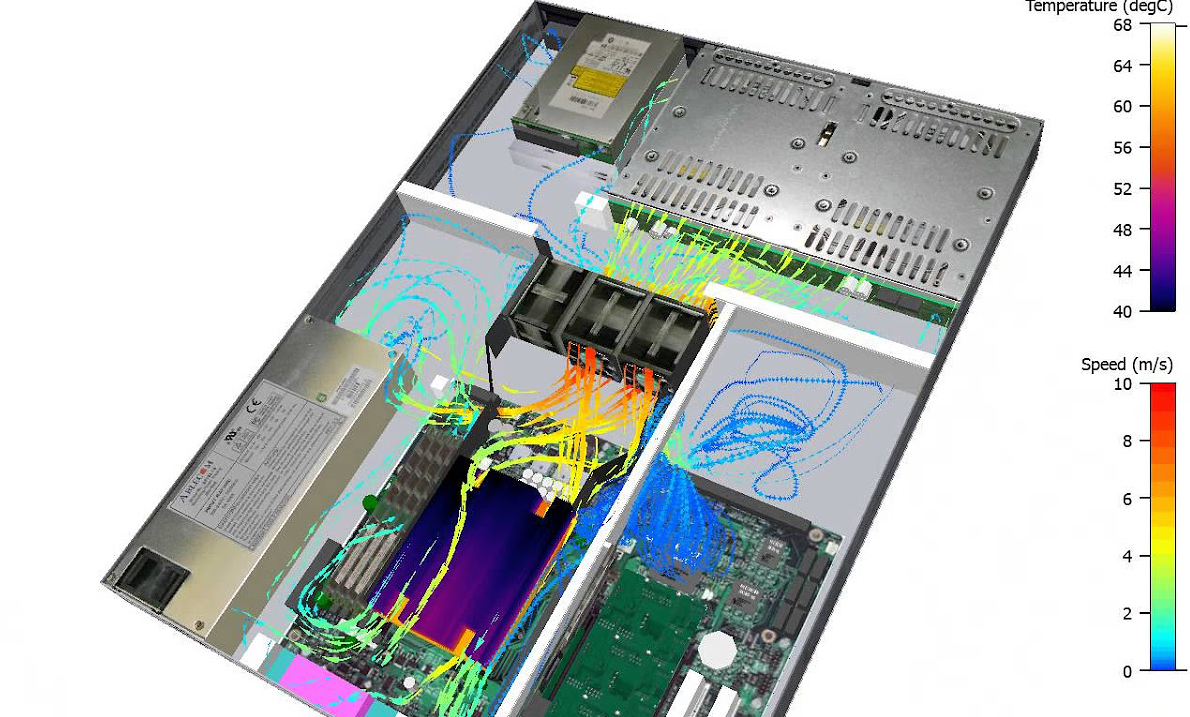
逼真視覺化後處理 Visual Editor
本產品視覺化後處理模組轉為提高電子設備散熱設計速度而研發。完全逼真的模型、三維流動動畫和處理溫度動態變化的工具,以及流動結果,協助工程師迅速高效地發現熱設計問題所在,並將設計修改以視覺化形式動態流線和示蹤粒子運動圖呈現。

參數最佳化分析和優化模組 Command Center
基於 SmartPart 的建模和結構化笛卡爾網格使得 Flotherm模型可採用 DOE 實驗設計 (Design of Experiments, DOE) 技術。實驗設計法是一種決定設計參數(比如:散熱器鰭片個數、通風孔位置等) 和結果(比如:發熱元件溫度、風扇流量等) 之間關係的結構化方法。本產品採用 DOE 技術後,在原始模型基礎上改變設計變數,求解大量不同參數的模型,可針對比不同設計參數模型的提供最佳化分析結果,儘量減少需要求解的類比模型。

FloEDA Bridge
FloEDA是EDA軟體與FloTHERM的轉換橋梁,將EE所設計好的PCB細部資訊透過此介面完整將IC封裝等資訊完整轉換至FloTHERM,再利用圖層轉換功能,將各銅層線路分佈等效呈現,達到快速建模與精準模擬的效果。支援Allegro、Boardstation、CR5000 Board Designer、Expedition、Allegro Package Designer (APD)等軟體,同時也支援IDF匯入。
Simcenter Flotherm 選購模組
FloMCAD Bridge
匯入ANSYS/Icepak 檔案至Flotherm (透過.ECXML),本產品客戶可以從SupportNet 下載Flotherm轉檔工具,直接將Icepak的檔案匯入至Flotherm中進行進一步的熱流分析。
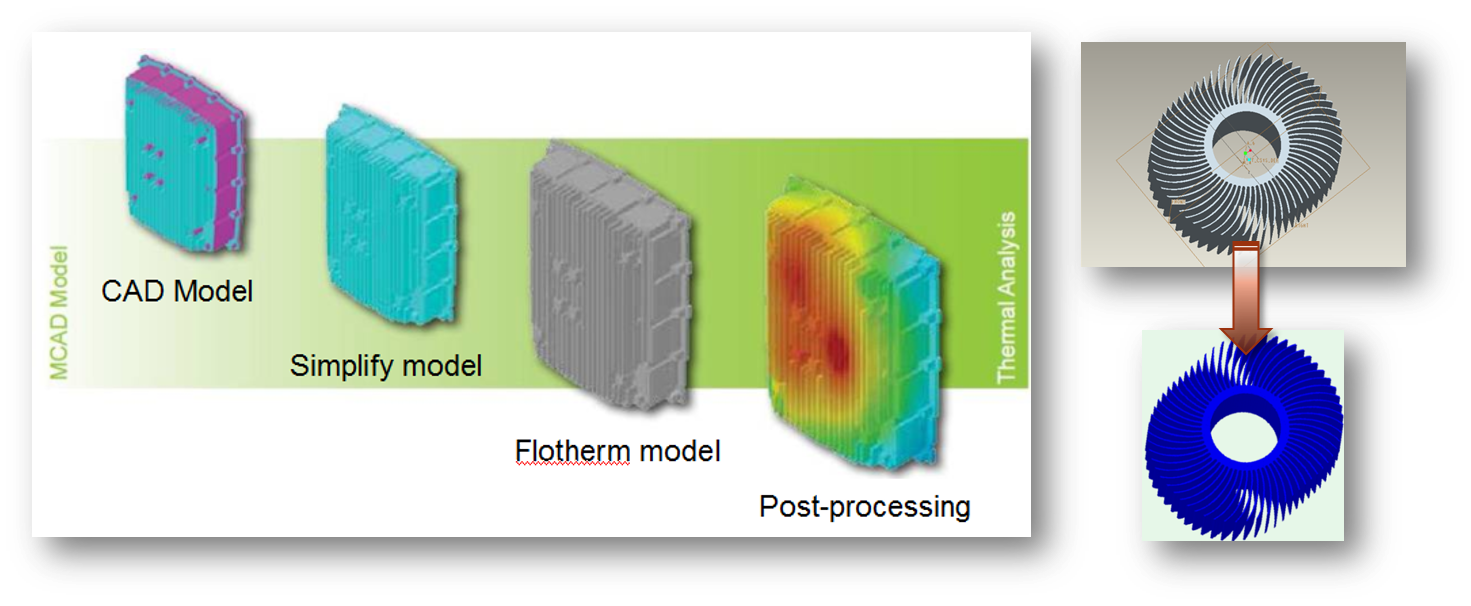
Flotherm Pack
Flotherm PACK 是一款網頁式的模組,提供可靠、準確的IC封裝以及相關器件的熱模型,而生成這些模型,僅需要用戶提供最基本的晶片封裝參數。為滿足封裝設計領域日益增強的創新意識而設計,其基於網路,並為每一個元件都設計了參數化設置功能表。比如,想要建立一個 BGA 封裝模型,您只需要輸入的下面這些資料:焊球/管腳數目、襯底傳導率、裸片尺寸以及襯底金屬層厚度以及覆蓋率。 其支持業內應用廣泛的所有封裝形式,包括球柵陣列封裝 (BGA),引線封裝 (Leaded Packages),針腳柵格陣列封裝 (Pin Grid Arrays), 電晶體外形封裝 (TransistorOutline Packages), 晶片 尺寸封裝 (Chip-Scale Packages) 以及堆疊封裝 (Multi-die Packages)。